
1 Introduzione
Nell'assemblaggio del circuito stampato, la pasta saldante viene prima stampata sulla piazzola di saldatura del circuito stampato, quindi vengono fissati i vari componenti elettronici. Infine, dopo il forno di rifusione, le perle di stagno contenute nella pasta saldante vengono fuse e tutti i tipi di componenti elettronici e la piazzola di saldatura del circuito stampato vengono saldati insieme per realizzare l'assemblaggio di sottomoduli elettrici. La tecnologia a montaggio superficiale (SMT) è sempre più utilizzata nei prodotti di packaging ad alta densità, come i pacchetti a livello di sistema (SIP), i dispositivi BallGridarray (BGA) e i dispositivi Power Bare Chip, ovvero i dispositivi con package quadrato piatto senza pin (Quad AAT-No-Lead, noti come QFN).
A causa delle caratteristiche del processo di saldatura a riflusso con pasta saldante e dei materiali, dopo la saldatura a riflusso di questi dispositivi con ampia superficie di saldatura, si formeranno dei fori nell'area di saldatura, che influenzeranno le proprietà elettriche, le proprietà termiche e le proprietà meccaniche delle prestazioni del prodotto e porteranno persino al guasto del prodotto, pertanto, migliorare la cavità di saldatura a riflusso con pasta saldante è diventato un processo e un problema tecnico che deve essere risolto, alcuni ricercatori hanno analizzato e studiato le cause della cavità di saldatura della sfera di saldatura BGA e fornito soluzioni di miglioramento, l'area di saldatura del processo di saldatura a riflusso con pasta saldante convenzionale di QFN maggiore di 10 mm2 o l'area di saldatura maggiore di 6 mm2 è carente nella soluzione bare chip.
Utilizzare la saldatura Preformsolder e la saldatura a riflusso sotto vuoto per migliorare il foro di saldatura. La saldatura prefabbricata richiede attrezzature speciali per la puntatura del flusso. Ad esempio, il chip viene spostato e inclinato notevolmente dopo essere stato posizionato direttamente sulla saldatura prefabbricata. Se il chip di montaggio del flusso viene rifuso e poi puntato, il processo aumenta di due volte e il costo della saldatura prefabbricata e del flusso è molto più elevato rispetto a quello della pasta saldante.
Le apparecchiature di riflusso sotto vuoto sono più costose, la capacità di vuoto della camera a vuoto indipendente è molto bassa, il rapporto costo-prestazioni non è elevato e il problema degli schizzi di stagno è serio, fattore importante nell'applicazione di prodotti ad alta densità e a passo piccolo. In questo articolo, basato sul processo convenzionale di saldatura a riflusso con pasta saldante, viene sviluppato e introdotto un nuovo processo di saldatura a riflusso secondario per migliorare la cavità di saldatura e risolvere i problemi di incollaggio e di rottura della guarnizione in plastica causati dalla cavità di saldatura.
2 Cavità di saldatura a riflusso per stampaggio di pasta saldante e meccanismo di produzione
2.1 Cavità di saldatura
Dopo la saldatura a riflusso, il prodotto è stato testato ai raggi X. I fori nella zona di saldatura con colore più chiaro sono stati riscontrati a causa di una saldatura insufficiente nello strato di saldatura, come mostrato nella Figura 1.
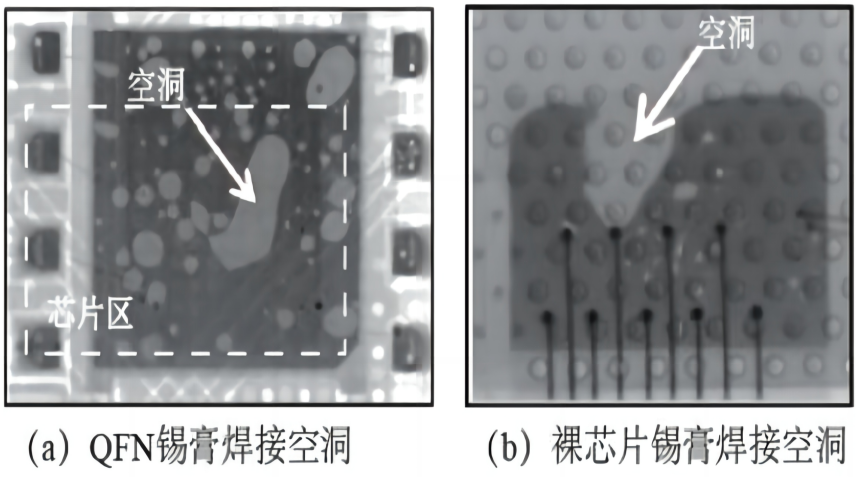
Rilevamento a raggi X del foro della bolla
2.2 Meccanismo di formazione della cavità di saldatura
Prendendo come esempio la pasta saldante sAC305, la composizione e la funzione principali sono illustrate nella Tabella 1. Il flusso e le perle di stagno sono legati insieme in forma di pasta. Il rapporto in peso tra stagno e flusso è di circa 9:1 e il rapporto in volume è di circa 1:1.

Dopo essere stata stampata e assemblata con vari componenti elettronici, la pasta saldante subirà quattro fasi di preriscaldamento, attivazione, riflusso e raffreddamento durante il passaggio attraverso il forno a riflusso. Anche lo stato della pasta saldante varia a seconda della temperatura raggiunta nelle diverse fasi, come mostrato in Figura 2.
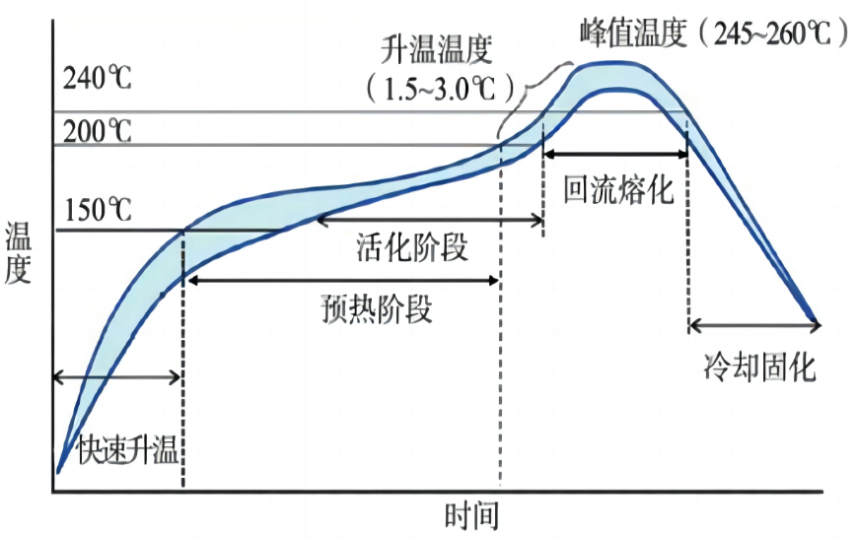
Riferimento del profilo per ogni area di saldatura a riflusso
Nella fase di preriscaldamento e attivazione, i componenti volatili del flusso nella pasta saldante si volatilizzeranno in gas quando riscaldati. Allo stesso tempo, si produrranno gas quando l'ossido sulla superficie dello strato di saldatura verrà rimosso. Alcuni di questi gas si volatilizzeranno e abbandoneranno la pasta saldante, e le perle di saldatura saranno fortemente condensate a causa della volatilizzazione del flusso. Nella fase di riflusso, il flusso rimanente nella pasta saldante evaporerà rapidamente, le perle di stagno si fonderanno, una piccola quantità di gas volatile del flusso e la maggior parte dell'aria tra le perle di stagno non si disperderanno in tempo, e i residui nello stagno fuso e sotto la tensione dello stagno fuso formano una struttura a sandwich e vengono catturati dalla piazzola di saldatura del circuito stampato e dai componenti elettronici, e il gas avvolto nello stagno liquido è difficile da fuoriuscire solo per galleggiamento verso l'alto. Il tempo di fusione superiore è molto breve. Quando lo stagno fuso si raffredda e diventa stagno solido, compaiono dei pori nello strato di saldatura e si formano dei fori di saldatura, come mostrato in Figura 3.
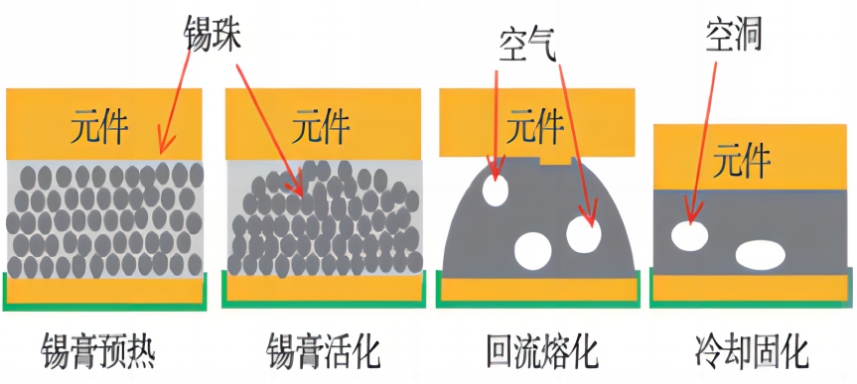
Diagramma schematico del vuoto generato dalla saldatura a riflusso della pasta saldante
La causa principale della cavità di saldatura è che l'aria o il gas volatile avvolto nella pasta saldante dopo la fusione non viene completamente scaricato. I fattori che influenzano la formazione di cavità includono il materiale della pasta saldante, la forma e la quantità di pasta saldante stampata, la temperatura e il tempo di riflusso, le dimensioni della saldatura, la struttura e così via.
3. Verifica dei fattori che influenzano la stampa della pasta saldante nei fori di saldatura a riflusso
Sono stati utilizzati test QFN e bare chip per confermare le principali cause dei vuoti di saldatura a rifusione e per trovare modi per migliorare i vuoti di saldatura a rifusione causati dalla pasta saldante. Il profilo del prodotto di saldatura a rifusione con pasta saldante QFN e bare chip è mostrato in Figura 4: le dimensioni della superficie di saldatura QFN sono 4,4 mm x 4,1 mm, la superficie di saldatura è uno strato stagnato (stagno puro al 100%); le dimensioni della saldatura del bare chip sono 3,0 mm x 2,3 mm, lo strato di saldatura è uno strato bimetallico di nichel-vanadio spruzzato e lo strato superficiale è di vanadio. La piazzola di saldatura del substrato è stata realizzata con doratura chimica in nichel-palladio e lo spessore era di 0,4 μm/0,06 μm/0,04 μm. Viene utilizzata la pasta saldante SAC305, l'attrezzatura per la stampa della pasta saldante è DEK Horizon APix, l'attrezzatura del forno a riflusso è BTUPyramax150N e l'attrezzatura a raggi X è DAGExD7500VR.
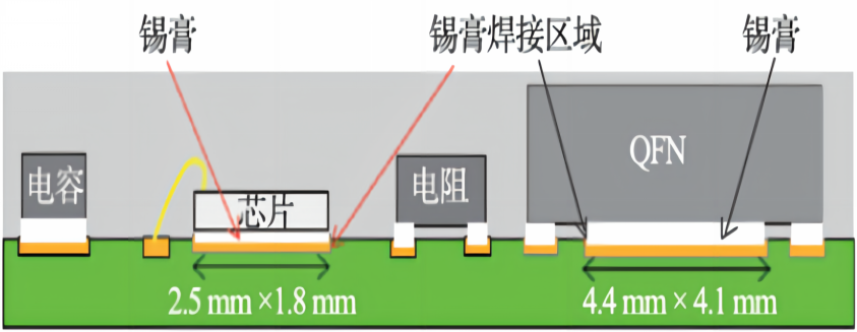
Disegni di saldatura QFN e bare chip
Per facilitare il confronto dei risultati dei test, la saldatura a riflusso è stata eseguita nelle condizioni indicate nella Tabella 2.

Tabella delle condizioni di saldatura a riflusso
Dopo aver completato il montaggio superficiale e la saldatura a riflusso, lo strato di saldatura è stato rilevato tramite raggi X e si è scoperto che c'erano grandi fori nello strato di saldatura nella parte inferiore del QFN e del chip nudo, come mostrato nella Figura 5.
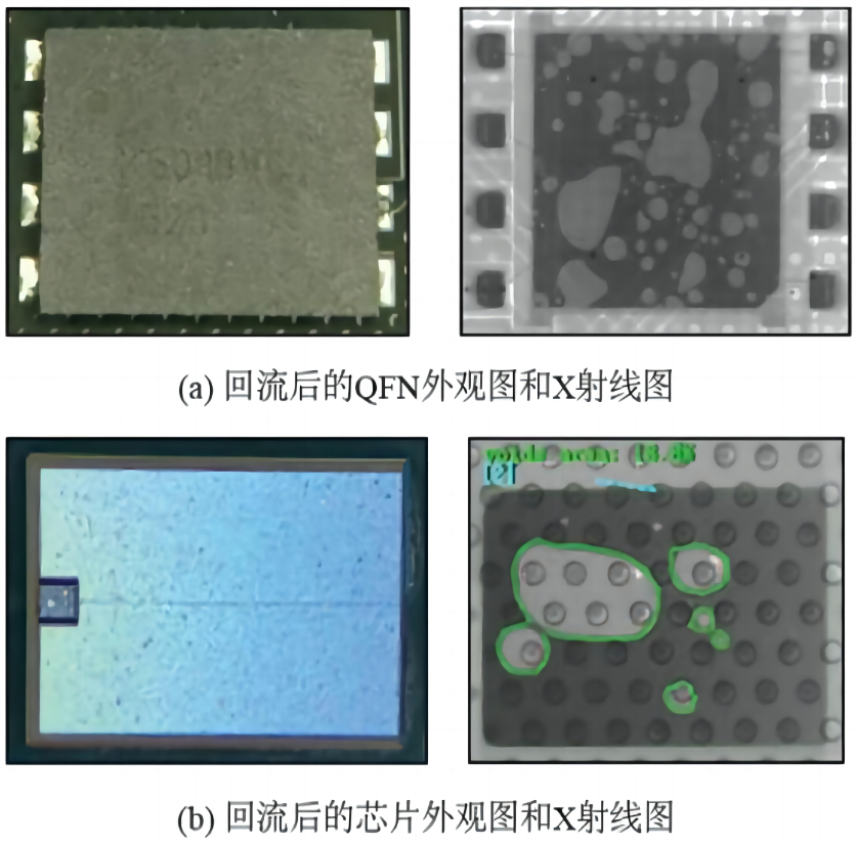
QFN e ologramma a chip (raggi X)
Poiché le dimensioni del cordone di stagno, lo spessore della maglia di acciaio, il tasso di apertura, la forma della maglia di acciaio, il tempo di riflusso e la temperatura massima del forno influiscono sui vuoti di saldatura a rifusione, vi sono molti fattori che influenzano la saldatura, che saranno verificati direttamente dal test DOE, e il numero di gruppi sperimentali sarà troppo elevato. È necessario selezionare e determinare rapidamente i principali fattori di influenza attraverso un test di confronto di correlazione, per poi ottimizzarli ulteriormente tramite DOE.
3.1 Dimensioni dei fori di saldatura e delle perle di stagno della pasta saldante
Con il test della pasta saldante SAC305 di tipo 3 (dimensione del cordone 25-45 μm), le altre condizioni rimangono invariate. Dopo la rifusione, i fori nello strato di saldatura vengono misurati e confrontati con quelli della pasta saldante di tipo 4. Si riscontra che i fori nello strato di saldatura non presentano differenze significative tra i due tipi di pasta saldante, il che indica che la pasta saldante con diverse dimensioni del cordone non ha un'influenza evidente sui fori nello strato di saldatura, che non costituisce un fattore determinante, come mostrato in FIG. 6.

Confronto di fori di polvere di stagno metallico con diverse dimensioni delle particelle
3.2 Spessore della cavità di saldatura e della rete di acciaio stampata
Dopo il reflow, l'area della cavità dello strato saldato è stata misurata con la maglia di acciaio stampata con spessore di 50 μm, 100 μm e 125 μm, mentre le altre condizioni sono rimaste invariate. Si è scoperto che l'effetto di diversi spessori di maglia di acciaio (pasta saldante) sul QFN è stato confrontato con quello della maglia di acciaio stampata con spessore di 75 μm. All'aumentare dello spessore della maglia di acciaio, l'area della cavità diminuisce gradualmente. Dopo aver raggiunto un certo spessore (100 μm), l'area della cavità si inverte e inizia ad aumentare con l'aumento dello spessore della maglia di acciaio, come mostrato in Figura 7.
Ciò dimostra che, aumentando la quantità di pasta saldante, lo stagno liquido con riflusso viene coperto dal chip e l'uscita dell'aria residua è stretta solo su quattro lati. Variando la quantità di pasta saldante, aumenta anche l'uscita dell'aria residua e l'esplosione istantanea di aria avvolta nello stagno liquido o di gas volatile che fuoriesce dallo stagno liquido causerà schizzi di stagno liquido attorno al QFN e al chip.
Il test ha rilevato che con l'aumento dello spessore della maglia d'acciaio aumenta anche lo scoppio delle bolle causato dalla fuoriuscita di aria o gas volatile e aumenta di conseguenza anche la probabilità che lo stagno schizzi attorno al QFN e al chip.

Confronto dei fori nelle maglie d'acciaio di diverso spessore
3.3 Rapporto di area tra la cavità di saldatura e l'apertura della maglia di acciaio
È stata testata la rete in acciaio stampata con un tasso di apertura del 100%, 90% e 80%, mantenendo invariate le altre condizioni. Dopo la rifusione, l'area della cavità dello strato saldato è stata misurata e confrontata con quella della rete in acciaio stampata con un tasso di apertura del 100%. Si è riscontrato che non vi erano differenze significative nella cavità dello strato saldato nelle condizioni di tasso di apertura del 100% e del 90%-80%, come mostrato in Figura 8.

Confronto delle cavità di diverse aree di apertura di diverse maglie di acciaio
3.4 Cavità saldata e forma di maglia di acciaio stampata
Con il test di forma di stampa della pasta saldante della striscia b e della griglia inclinata c, le altre condizioni rimangono invariate. Dopo il reflow, l'area della cavità dello strato di saldatura viene misurata e confrontata con la forma di stampa della griglia a. Si riscontra che non vi è alcuna differenza significativa nella cavità dello strato di saldatura nelle condizioni di griglia, striscia e griglia inclinata, come mostrato in Figura 9.
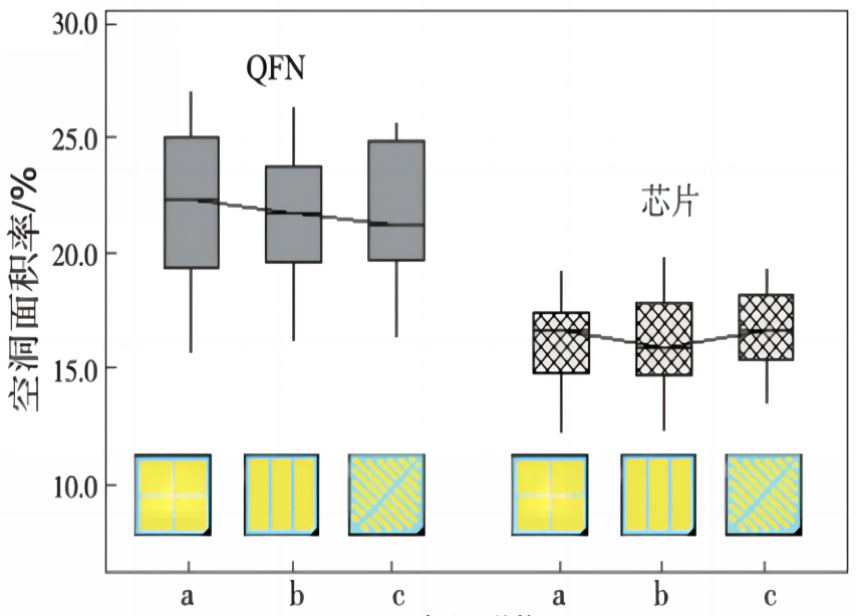
Confronto dei fori nelle diverse modalità di apertura della rete metallica
3.5 Cavità di saldatura e tempo di riflusso
Dopo un test con tempo di riflusso prolungato (70 s, 80 s, 90 s), le altre condizioni sono rimaste invariate. Il foro nello strato di saldatura è stato misurato dopo il riflusso e, confrontato con il tempo di riflusso di 60 s, si è riscontrato che con l'aumento del tempo di riflusso, l'area del foro di saldatura diminuiva, ma l'ampiezza della riduzione diminuiva gradualmente con l'aumento del tempo, come mostrato in Figura 10. Ciò dimostra che in caso di tempo di riflusso insufficiente, l'aumento del tempo di riflusso favorisce il pieno traboccamento dell'aria avvolta nello stagno liquido fuso, ma dopo che il tempo di riflusso aumenta fino a un certo tempo, l'aria avvolta nello stagno liquido difficilmente trabocca di nuovo. Il tempo di riflusso è uno dei fattori che influenzano la cavità di saldatura.

Confronto vuoto di diverse lunghezze di tempo di reflusso
3.6 Temperatura della cavità di saldatura e temperatura massima del forno
Con una temperatura di picco del forno di 240 ℃ e 250 ℃ e altre condizioni invariate, l'area della cavità dello strato saldato è stata misurata dopo la rifusione e confrontata con una temperatura di picco del forno di 260 ℃; si è scoperto che in diverse condizioni di temperatura di picco del forno, la cavità dello strato saldato di QFN e chip non cambiava in modo significativo, come mostrato nella Figura 11. Ciò dimostra che diverse temperature di picco del forno non hanno alcun effetto evidente su QFN e sul foro nello strato di saldatura del chip, che non è un fattore influente.

Confronto vuoto di diverse temperature di picco
I test sopra indicati indicano che i fattori significativi che influenzano la cavità dello strato di saldatura del QFN e del chip sono il tempo di reflusso e lo spessore della maglia di acciaio.
4 Miglioramento della cavità di saldatura a riflusso per stampaggio con pasta saldante
4.1Test DOE per migliorare la cavità di saldatura
Il foro nello strato di saldatura di QFN e chip è stato migliorato individuando il valore ottimale dei principali fattori di influenza (tempo di reflusso e spessore della maglia di acciaio). La pasta saldante era di tipo SAC3054, la forma della maglia di acciaio era di tipo grigliato (grado di apertura del 100%), la temperatura di picco del forno era di 260 °C e le altre condizioni di prova erano le stesse di quelle dell'apparecchiatura di prova. Il test DOE e i risultati sono mostrati nella Tabella 3. L'influenza dello spessore della maglia di acciaio e del tempo di reflusso sui fori di saldatura di QFN e chip è mostrata nella Figura 12. Attraverso l'analisi dell'interazione dei principali fattori di influenza, si è scoperto che l'utilizzo di uno spessore della maglia di acciaio di 100 μm e di un tempo di reflusso di 80 s può ridurre significativamente la cavità di saldatura di QFN e chip. Il tasso di cavità di saldatura di QFN è ridotto dal massimo del 27,8% al 16,1% e il tasso di cavità di saldatura di chip è ridotto dal massimo del 20,5% al 14,5%.
Nel test, sono stati realizzati 1000 prodotti in condizioni ottimali (spessore della maglia d'acciaio di 100 μm, tempo di riflusso di 80 s) e la velocità di cavità di saldatura di 100 QFN e truciolo è stata misurata casualmente. La velocità media di cavità di saldatura di QFN era del 16,4% e la velocità media di cavità di saldatura del truciolo era del 14,7%. La velocità di cavità di saldatura del truciolo e del truciolo sono ovviamente ridotte.

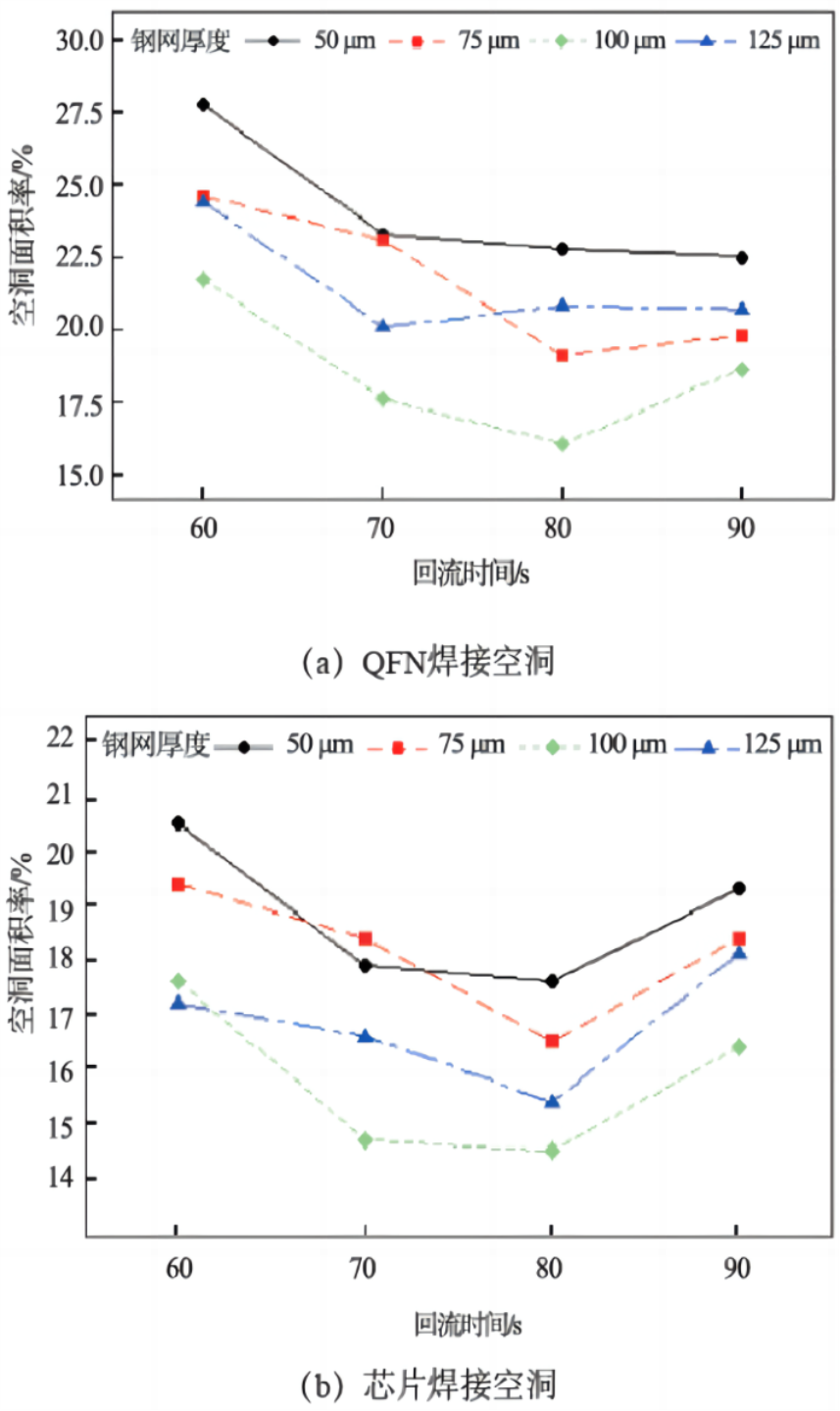
4.2 Il nuovo processo migliora la cavità di saldatura
L'attuale situazione produttiva e i test dimostrano che quando l'area della cavità di saldatura sul fondo del chip è inferiore al 10%, il problema delle cricche nella posizione della cavità del chip non si verifica durante la saldatura e lo stampaggio dei conduttori. I parametri di processo ottimizzati dal DOE non soddisfano i requisiti di analisi e risoluzione dei fori nella saldatura a rifusione con pasta saldante convenzionale, e l'area della cavità di saldatura del chip deve essere ulteriormente ridotta.
Poiché il chip ricoperto dalla saldatura impedisce la fuoriuscita del gas presente nella saldatura, la velocità dei fori sul fondo del chip viene ulteriormente ridotta eliminando o riducendo il gas rivestito dalla saldatura. Viene adottato un nuovo processo di saldatura a riflusso con due stampi di pasta saldante: uno con la pasta saldante, uno a riflusso che non copre il QFN e il chip nudo che scarica il gas nella saldatura; il processo specifico di stampaggio secondario della pasta saldante, patch e riflusso secondario è illustrato nella Figura 13.
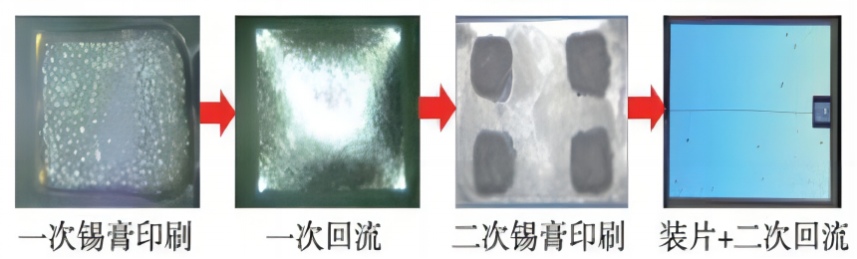
Quando la pasta saldante da 75 μm di spessore viene stampata per la prima volta, la maggior parte del gas presente nella pasta saldante senza copertura del chip fuoriesce dalla superficie e lo spessore dopo il riflusso è di circa 50 μm. Dopo il completamento del riflusso primario, sulla superficie della pasta saldante solidificata e raffreddata vengono stampati dei piccoli quadrati (per ridurre la quantità di pasta saldante, ridurre la fuoriuscita di gas e ridurre o eliminare gli schizzi di saldatura) e la pasta saldante con uno spessore di 50 μm (i risultati dei test sopra riportati mostrano che 100 μm è il migliore, quindi lo spessore della stampa secondaria è di 100 μm. 50 μm = 50 μm), quindi si installa il chip e si ritorna per 80 secondi. Non vi è quasi alcun foro nella pasta saldante dopo la prima stampa e il riflusso, e la pasta saldante nella seconda stampa è piccola, così come il foro di saldatura, come mostrato in Figura 14.
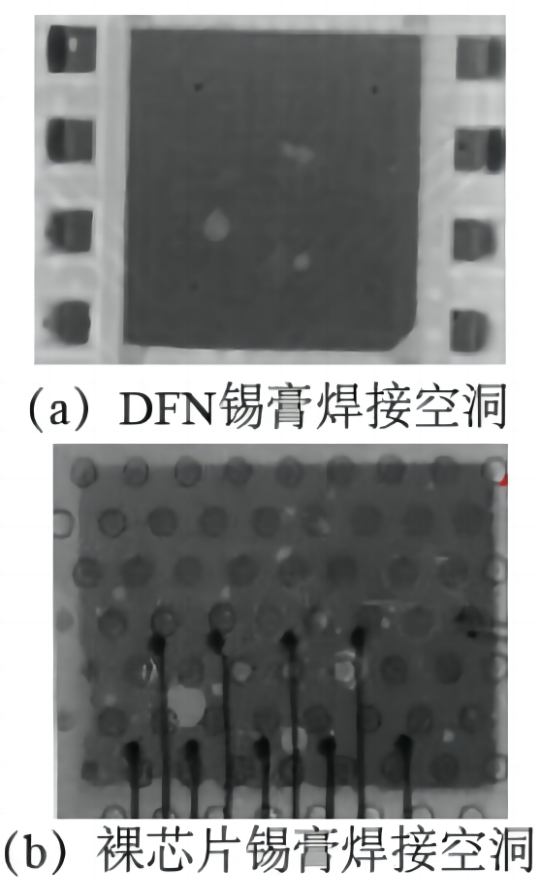
Dopo due stampe di pasta saldante, disegno cavo
4.3 Verifica dell'effetto della cavità di saldatura
Produzione di 2000 prodotti (lo spessore della prima maglia di acciaio da stampa è 75 μm, lo spessore della seconda maglia di acciaio da stampa è 50 μm), altre condizioni invariate, misurazione casuale di 500 QFN e tasso di cavità di saldatura del chip, ha rilevato che il nuovo processo dopo il primo riflusso nessuna cavità, dopo il secondo riflusso QFN Il tasso massimo di cavità di saldatura è del 4,8% e il tasso massimo di cavità di saldatura del chip è del 4,1%. Rispetto al processo di saldatura a stampa a pasta singola originale e al processo ottimizzato DOE, la cavità di saldatura è significativamente ridotta, come mostrato nella Figura 15. Non sono state riscontrate crepe nel chip dopo i test funzionali di tutti i prodotti.

5 Riepilogo
L'ottimizzazione della quantità di pasta saldante e del tempo di riflusso può ridurre l'area della cavità di saldatura, ma la velocità di saldatura rimane elevata. L'utilizzo di due tecniche di saldatura a riflusso con pasta saldante può massimizzare efficacemente la velocità di saldatura. L'area di saldatura del chip nudo del circuito QFN può essere rispettivamente di 4,4 mm x 4,1 mm e 3,0 mm x 2,3 mm nella produzione di massa. La velocità di saldatura a riflusso è controllata al di sotto del 5%, il che migliora la qualità e l'affidabilità della saldatura a riflusso. La ricerca in questo articolo fornisce un importante riferimento per migliorare il problema della cavità di saldatura su superfici di saldatura di grandi dimensioni.
Data di pubblicazione: 05-07-2023







